走向工业界!晶圆级超表面光刻技术
近年来,超表面已成为纳米光子学中发展最快的领域之一。它是由亚波长尺度单元组成,可以精确控制的相移从0到2π。在聚焦、偏振控制、表面等离子体激元操纵、光谱滤波、光涡流处理、光束偏转、全息影像等领域有着广泛的用途。
目前,大多数基于超表面的器件都是使用电子束光刻(EBL)或聚焦离子束(FIB)来图案化的。对于大规模的纳米结构图形化,EBL和FIB需要较长的处理时间,因此不适合大规模生产。相比之下,光刻技术能够在短时间内刻制出大规模的纳米结构。
近日,新加坡A*STAR微电子研究中心的Nanxi Li等人在Nanophotonics上发表综述,总结了使用CMOS兼容的光刻技术来制备大面积纳米结构超表面的最新工作,主要包括控制步长来光刻超表面器件的开拓性工作,以及采用沉浸式光刻技术制备超表面器件的工作,详细的介绍了器件的制备步骤和器件性能,并指出光刻技术在超表面制备方面在未来的发展方向和面临问题。
01
光刻步进器的超表面图案化
科研人员用带有365 nm光源的步进器对近红外,中红外超表面进行了图形化。同时,人们利用248 nm光源的步进器制备了在可见波长范围内工作的超透镜。
工作波长为1550 nm的大面积超透镜(直径为2 cm)的制作工艺流程如图1A所示。步进器(GCA AS200 i-line365 nm步进器)用于在4英寸玻璃基板上通过等离子体增强化学气相沉积(PECVD)生长出a-Si层。采用反应离子刻蚀工艺制备了600 nm高的纳米子。
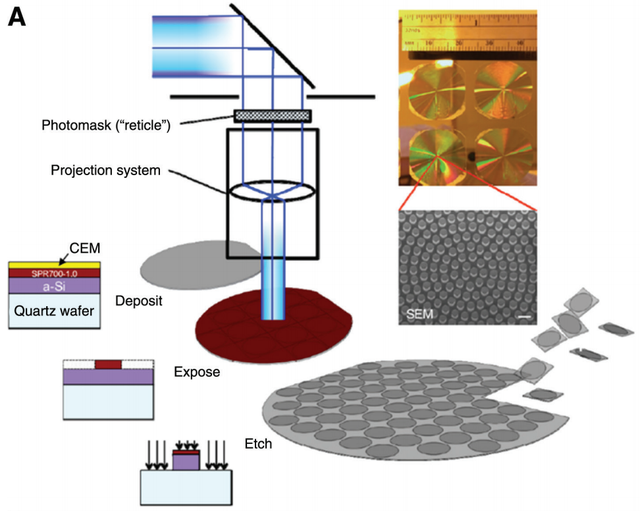
图1. 1550 nm大面积超透镜加工工艺示意图。
在玻璃或SOI基板上的中红外超透镜是使用相同的i-line365 nm步进器进行图形化的。
图2A展示了基于SOI晶圆片的制作过程,这使得后期MEMS扫描集成膜的形成成为可能。该超透镜的结构单元如图2B所示。额外的底部蚀刻过程应用于硅衬底形成2.8 μm厚的膜。随后用FIB工具中的针切断并连接到MEMS扫描仪上实现可调谐的目的,如图2D所示。该系统演示了沿两个正交轴与±9°进行二维扫描,使动态波束具有转向能力。

图2. 用365 nm光源的步进器给中红外波段超表面器件图案化
对于在可见波长范围内工作的超表面,与在红外波长范围内工作的器件相比,需要一个更小的图形临界尺寸。因此,一种248 nm源波长的步进器直接将逐渐变细的纳米柱图案光刻在4英寸玻璃上。氧化硅纳米柱直径从250 nm到600 nm,边缘空隙250 nm,工艺流程如图3A所示。图3B展示了刻蚀后超透镜的SEM形貌图以及一个含有45个超透镜金属玻璃晶圆片。研究人员对该超透镜进行测量并给出了不同波长的焦平面光强分布,如图3C所示。该超透镜的成像能力如图3D所示。该图是科学CMOS相机捕捉到的在超透镜附近表面彩色图像。
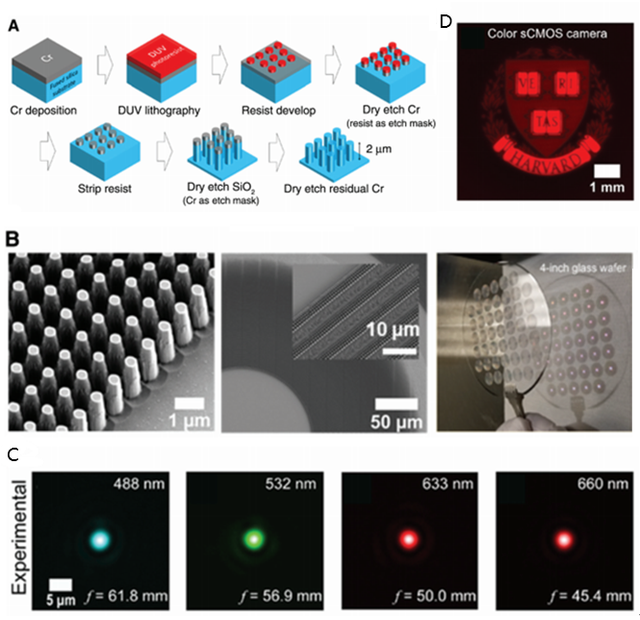
图3. 用248 nm光源的步进器给可见光波段的超表面器件图案化
02
沉浸式光刻技术制备超表面器件
本节主要介绍在12 英寸硅晶圆和玻璃晶圆上制备超表面器件。
对于硅衬底,目前有两种方法,一种是直接在硅晶圆上刻蚀,另一种是在介电层光刻图案化。
对于玻璃衬底,同样有两种方法,一种是转移法,直接从硅晶圆转移到玻璃上,一种是直接在玻璃上进行光刻图案化。
工艺流程是在IME内部使用最先进的技术开发的193 nm 12英寸沉浸式扫描仪,与上一节的工作相比,该技术使得基于超表面的设器件具有更小的临界尺寸和更大的体积。图4B展示了一个12英寸硅片切片前的情况。
2.1硅衬底
图4A展示了第一种方法:直接在12英寸硅晶圆上刻蚀。采用193nm深紫外光浸没扫描仪对光刻胶进行扫描,然后采用电感耦合等离子体(ICP)刻蚀工艺。根据基于超表面器件的应用,结构单元在形状和尺寸方面有不同的设计。采用直接刻蚀工艺制作的金字塔形结构单元的SEM,TEM图像如图4C所示。

图4. 采用浸没扫描仪直接在12英寸硅晶圆上光刻超表面图案
第二种方法的工艺流程如图5A所示。与第一种方法相比,第二种方法是在介电层的顶部进行图形化和刻蚀。这层介电层的折射率应低于第二层介电层。第一层介电层材料可以为氧化硅,氮化硅,氧化铝,氮化铝氧化硅/氮化硅多层等。第二层介电层材料可以为a-Si,氧化钛,氮化硅等。
图5B显示了一个制备好的晶圆片,其中的插图显示了可见波长范围内的反射滤色片。基于超表面的滤光片的示意图图如图5C所示。通过改变柱直径和节距大小,形成滤色效果。三个字母“I”“M”“E”的顶视图SEM图像如图5D所示。
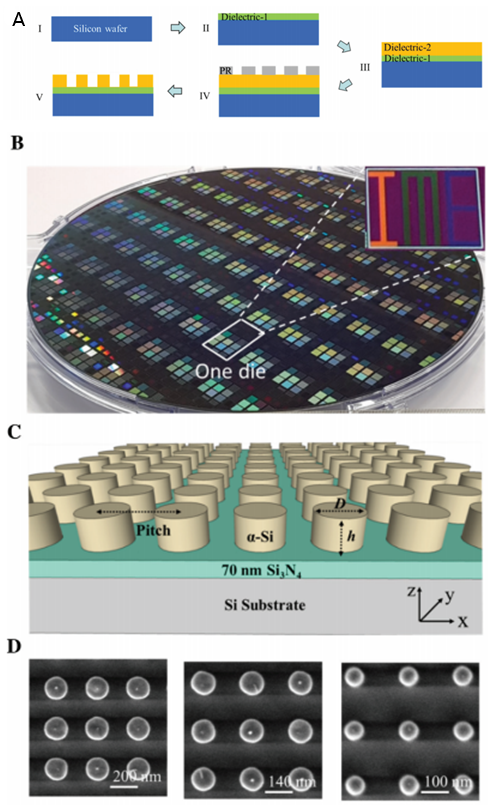
图5. 用浸没扫描仪在硅晶圆上的介电层上进行超表面器件的图案化
2.2玻璃衬底
在1.1 um以上波长工作的超表面,硅可以作为衬底因为其在这个波段范围是透明的而且与CMOS工艺兼容。当需要工作波段变短,玻璃/石英由于其在短波段透明而被采用。同时,直接在玻璃/石英衬底上直接做纳米结构可能是具有挑战的,因为大多数CMOS工艺以及响应的CVD,PVD,光刻,刻蚀等都是为硅晶圆服务的。因此制备和表征工具需要修正,新的工艺方案需要开发。
目前优化的方法是IME开发的将超表面层转移到12英寸的玻璃晶圆基板上。在晶圆片基板上制备超表面层的工艺流程如图6A所示。对上介电层进行图形化和蚀刻后,在上表面旋涂上一层透明的粘结胶,如图6A中步骤I和步骤II所示。接下来,晶圆片与玻璃晶圆结合(步骤III)。随后进行背面减薄,使硅厚度从750 um减少到20 um。然后用湿蚀刻或干蚀刻(第IIII步)除去剩余的硅。第一层介电层起到刻蚀停止的作用。图6B展示了制作的照片12英寸的玻璃晶元片。图6C显示了该晶圆片上超透镜原理图。图6D展示了其ICP后的SEM图,光学图像,指纹图像。

图6. 在12英寸玻璃上采用浸没扫描仪和转移法制备超表面器件
前面提到的层转移过程需要粘结剂,它的折射率接近于玻璃,因此限制了纳米柱与周围材料的折射率对比。为了增加折射率对比度和减少制备步骤,研究人员开发了直接在12英寸的玻璃晶圆片上进行图形化和蚀刻。制备工艺流程如图7A所示。通过直接刻蚀制作的12英寸玻璃晶圆片的照片如图7B所示。
作为一个概念验证的演示,大面积超透镜被设计为直径8 mm。玻璃基板上大面积超透镜的原理图已经响应的SEM图如图7C所示,直接作用于玻璃晶圆上的纳米柱的圆形形状可以在超透镜的中心区域清晰地观察到。晶圆片级制作及检验完成后,将晶圆片切割成26×33 mm的小片。切割超透镜的照片如图7D所示。
为了测试器件的聚焦功能,制作的超透镜被安装到表征设备上。在设计的焦距为8 mm时,可以清晰地观察到聚焦效果。焦平面上光斑大小为1.5 μm。
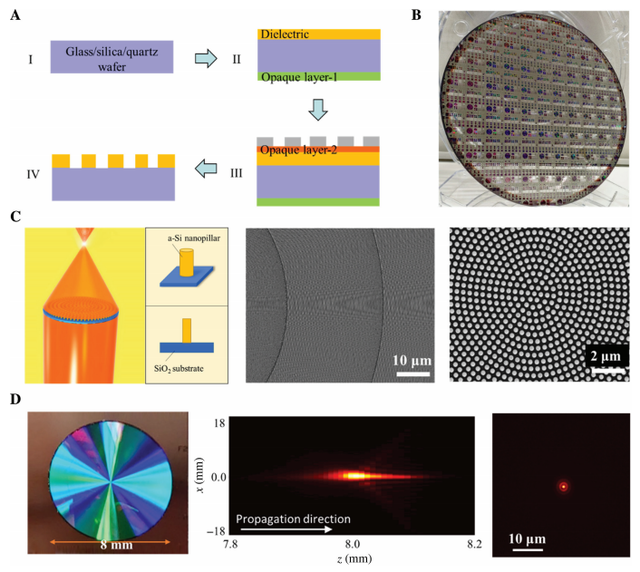
图7. 直接在22英寸玻璃上光刻超表面图案
03
总结与展望
基于光刻技术用于大面积大规模生产的基于超表面的功能器件研究方向的总结,作者建议一系列的光刻超表面未来发展方向。研究和开发工作可以放在以下四个方面:
一、首先,使用12英寸193 nm浸没式光刻技术在IME平台上的纳米结构和临界尺寸(CD)限制在60到70 nm。这样的光盘尺寸能够实现在可见波长范围内工作的高性能平面光学元件。CD可以通过优化光刻工艺进一步减少,例如,使用多个图案。更小的CD将能够实现消色差平面光学元件设计以及减小器件的工作波长。
二、随着更多平台材料的开发,在玻璃上直接进行超表面的图案化处理能够进一步得到优化和发展。
三、可以开发基于超表面的器件与MEMS器件的单片集成的可能性,从而在这些制造平台上实现可调的超表面。
四、重点可以放在基于超表面的器件的模块级封装上,用发光二极管和光电探测器等器件组成一个功能模块。封装工艺可以采用成熟的半导体器件封装技术。功能模块的应用包括光学指纹、飞行时间传感器、虚拟现实和增强现实。此外,也需要发展晶圆级封装,以实现大规模生产的模块,进一步降低制造成本。
文章信息:
该综述文章以“ Large-area metasurface on CMOS-compatible fabrication platform: driving flat optics from lab to fab ”为题发表在 Nanophotonics 期刊。
论文地址:
https://doi.org/10.1515/nanoph-2020-0063






















评论