超宽禁带AlN材料及其器件应用的现状和发展趋势
本文内容转载自《半导体技术》2019年第4期,版权归《半导体技术》编辑部所有。
何君,李明月
中国电子科技集团公司第十三研究所
摘要:作为一种Ⅲ-Ⅴ族化合物半导体材料,AlN不仅具有超宽直接带隙(6.2 eV)、高热导率、高电阻率、高击穿场强、优异的压电性能和良好的光学性能,而且AlN晶体还与其他Ⅲ-N材料具有非常接近的晶格常数和热膨胀系数。这些特点决定了AlN在GaN外延、紫外光源、辐射探测器、微波毫米波器件、光电器件、电力电子器件以及声表面波器件等领域具有广阔的应用前景。介绍了AlN材料在功率器件、深紫外LED、激光器、传感器以及滤波器等领域的应用现状,并对AlN材料及其应用的未来发展趋势进行了分析和展望。
关键词:AlN;超宽禁带;光电器件;电力电子器件;声表面波(SAW)器件
0 引言
AlN材料具有很高的直接带隙(6.2 eV),是重要的蓝光和紫外发光材料;AlN介电常数小,具有良好热导率、高电阻率和击穿场强,是优异的高温、高频和大功率器件材料;沿c轴取向的AlN具有良好的压电性和极高的声表面波(SAW)传输速度,是极佳的SAW器件用压电材料。AlN晶体与其他Ⅲ-N材料具有非常接近的晶格常数和热膨胀系数,与蓝宝石或SiC衬底相比,AlN与AlGaN的晶格常数匹配、热匹配及化学兼容性更高,作为AlGaN器件外延衬底时可大幅度降低器件中的缺陷密度。AlN的这些优良性能使其在众多领域中具有广阔的应用前景,成为目前国际研究的热点。近年来,国际上对AlN研究的热点主要包括以下几个方面:① AlN外延及制备技术;② AlN基器件衬底技术;③ AlN接触和掺杂层技术;④ 深紫外(DUV)电子器件应用的AlN功能层特性;⑤ AlN深紫外LED和传感器技术;⑥ AlN深紫外激光器及其应用;⑦ 使用AlN材料的电子器件技术(HEMT、功率器件和高频器件)⑧ AlN材料的新应用(压电器件、太赫兹器件、高温电子器件等)。
本文主要介绍了AlN材料的制备技术以及在功率器件、光电器件、电力电子器件、传感器以及滤波器等领域的应用现状,并对AlN材料及其器件应用的未来发展趋势进行了分析和展望。
1 AlN的制备方法
AlN单晶的制备方法主要包括分子束外延(MBE)、氢化物气相外延(HVPE)、金属有机化合物气相淀积(MOCVD)和物理气相传输(PVT)法等。其中HVPE、MOCVD和MBE法多用来制备薄膜,HVPE生长速度快(100 μm/h),几乎是MOCVD和MBE法的100倍,适合制作较厚的AlN薄膜。PVT技术的基本原理为高温区AlN源的分解升华,通过温度梯度驱动至籽晶表面重新凝华成晶体,其生长速度比HVPE更快、晶体质量更高,是目前制备大尺寸、高质量AlN体单晶最有前景的方法之一,也是目前的国际研究热点。
目前美国Crystal IS公司和俄罗斯的Nitride Crystals公司掌握了PVT法制备AlN晶体的核心技术,在该领域处于领先地位,2012年已制备出直径大于2英寸(1英寸 = 2.54 cm)的AlN体单晶。使用PVT法进行材料制备主要有3个研究方向:籽晶自发成核技术;同质外延自发成核技术;SiC衬底上的异质外延引晶技术。自发成核技术获得的AlN晶体质量相对较高,生长速度较快,但无法实现大尺寸晶体;同质外延成核技术是AlN晶体生长的最终目标,然而大尺寸高质量晶体难以实现。随着4英寸SiC晶圆实现大规模商品化,外延引晶技术无疑成为快速实现大尺寸AlN衬底最直接有效的方法,然而该方法生长出来的AlN晶体杂质、位错和微管缺陷偏高,可采用SiC / AlN复合籽晶生长技术制备出大尺寸AlN晶体。
2018年,美国的I. Demir等人报道了一种采用MOCVD法制备的“三明治”结构高质量AlN,这种较厚的(2 μm)无断裂AlN材料制作在c平面蓝宝石衬底上,“三明治”结构是在两个较高温度(1170 °C)生长的250 nm厚的AlN层中夹有一层较低温度(1050 ℃)生长的1500 nm厚的AlN层,这种结构使晶体质量和晶体表面形貌得到明显改观,5 μm × 5 μm面积的均方根粗糙度为0.71 nm。
与MOCVD和MBE法相比,HVPE法生长速度快,是一种具有发展前景的AlN薄膜制备技术,但其生长效率低、成本高。2016年,俄罗斯的V. N. Bessolov等人报道了采用氯化物HVPE技术在SiC / Si衬底上制作无应变(约为0.02 GPa)AlN薄膜层的方法,配合新型外延横向过生长(ELO)技术和悬空外延片技术制作出20 μm厚的AlN外延薄膜,生长温度为1080 ℃,生长速率为0.2 μm/min。
2016年,中国科学院物理研究所的胡伟杰等人采用PVT法制备了1英寸AlN单晶并对p型掺杂进行了研究。徐永宽等人和郝建民报道了在碳基单晶生长系统中采用SiC籽晶和在钨材质单晶生长系统中自发成核PVT法制备大尺寸AlN单晶及抛光片,为AlGaN器件使用AlN同质衬底提供了可能性。
2 AlN在器件中的应用
AlN主要用于微波毫米波器件、SAW器件、紫外/深紫外LED以及电力电子器件。其中AlN紫外LED的输出功率已达到实用化需求,紫外/深紫外探测器仍在研制阶段,中功率吉赫兹级通信用HEMT和SAW/体声波(BAW)压电器件正步入实用化阶段。此外,AlN大功率电力电子器件进入快速发展期,新型AlN器件如MEMS器件、太赫兹器件、高温器件等处于不断探索和开发中。
2.1 微波毫米波器件
AlN在微波毫米波器件已有广泛应用,如使用AlN缓冲层可使GaN / Si器件的电子迁移率比使用SiC或蓝宝石缓冲层提高1~3倍;AlN成核层是在Si基底上外延生长Ⅲ-N材料的重要步骤;薄AlN势垒层可有效解决GaN器件由于势垒下降所引起的二维电子气(2DEG)密度下降问题;高Al组分AlxGa1-xN(x > 0.5) / AlN的击穿电压是GaN的3倍,热导率是蓝宝石的6倍、GaN的1~2倍,是理想的沟道层材料;AlN衬底与蓝宝石或SiC衬底相比可使GaN器件的位错密度从108 cm-2下降到105 cm-2数量级,在AlN衬底上生长高Al组分AlGaN薄膜具有更低的位错密度和自补偿特性,因而展现出极高峰值导电性、载流子浓度和迁移率,将成为替代蓝宝石或SiC的重要衬底材料。
2.1.1 HEMT器件
AlN通常用于HEMT器件的缓冲层和势垒层,可使器件实现更高的输出功率、截止频率、抗辐射能力以及耐恶劣环境特性,是宽禁带氮化物半导体和微电子领域的前沿技术。
2018年,美国桑迪亚实验室报道了高Al组分(85%)AlN / Al0.85Ga0.15N HEMT,其结构如图1所示,研究人员使用AlN势垒刻蚀去除和再生长工艺形成欧姆接触,2DEG电阻率接近4200 Ω/□,击穿电压高达810 V,具有极佳的栅漏电流,开关电流比(Ion / Ioff> 107)和亚阈值斜率(75 mV/dec)。2017年,S. Muhtadi等人对蓝宝石衬底上3 μm厚的低缺陷AlN缓冲层Al0.85Ga0.15N/ Al0.65Ga0.35N HEMT器件进行了研究,证明AlN缓冲层可提供足够高的热导率,当源—漏间距为5.5 μm、栅长为1.8 μm时,器件在栅偏压为4 V时的峰值漏电流高达250 mA/mm,器件可在40 V和250 mA/mm条件下稳定工作,没有出现电流崩塌现象。2017年,德国弗劳恩霍夫研究所的B. J. Godejohann等人分别采用MBE和MOCVD法制作了AlN / GaNHEMT,并对两种方法进行了对比:采用蓝宝石衬底MBE法生长出陡峭界面和纯AlN势垒层,Si衬底MOCVD生长的AlN纯度不如MBE法,器件的最高漏电流约为1.46 A/mm,栅源电压为3 V,截止频率为89 GHz,薄膜电阻小于200 Ω/□,在100 nm栅长下AlN / GaN HEMT器件实现了极佳的高频和小信号特性。2018年,土耳其的I. K. Durukan等人推出了两种采用MOCVD法生长的不同AlN缓冲层厚度(260 nm和520 nm)的蓝宝石衬底AlGaN / AlN / GaN异质结构HEMT,并对两种结果进行了对比,通过X射线衍射(XRD)和原子力显微镜(AFM)进行研究,其结果表明,使用260 nm厚缓冲层的器件具有更多的凹坑和突起,粗糙度更高。同年,印度的P.Murugapandiyan等人报道了一种新型T型栅20 nm增强模式Al0.5Ga0.5N / AlN / GaN HEMT,器件采用重掺杂源—漏区和Al2O3钝化层,截止频率(ft)和最高振荡频率(fmax)分别为325 GHz和553 GHz,采用2 nm厚的AlN势垒层使峰值漏电流密度达到3 A/mm,约翰逊优值为8.775 THz,其良好特性使其成为下一代大功率毫米波RF应用的单片微波集成电路最合适的候选技术。
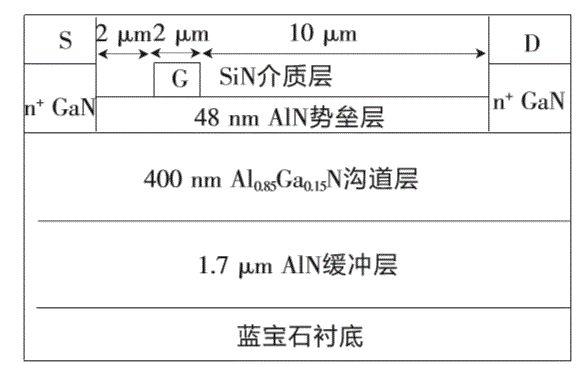
图1 高Al组分AlN / AlGaN HEMT结构示意图
2018年,张力江等人在SiC衬底上制备低缺陷AlN缓冲层,研制了一款L波段350 W AlGaN / GaN HEMT大功率器件,器件增益大于13 dB,效率高达81%。可靠性试验结果表明,器件抗失配能力达到10∶1。
2.1.2 FET器件
AlN通常用于FET器件的缓冲层、绝缘层、势垒层和衬底,AlN / GaN异质结FET具有很高的2DEG面密度和电子迁移率,传输特性优良,在电力电子器件和射频器件领域有着非常广阔的应用前景。髙温应用也是AlN异质结FET的重要优势之一。
2016年,日本的N. Kurose等人报道了一种Si衬底上通过形成纳米尺寸自发通孔成功制作的导电AlN缓冲层垂直型AlGaN FET,通过在通孔中填充导电n - AlGaN使AlN的垂直导电率提高了1000倍,通过这种导电通孔AlN技术成功设计出350 nm垂直型UV - LED和垂直型UV传感器,193 nm时的响应度达到150 mA/W。同年,日本的R. G. Banal等人报道了一种采用AlN绝缘层的AlN / Al2O3堆叠栅H终端金刚石金属—绝缘体—半导体场效应晶体管(MISFET),5 nm厚的Al2O3层和175 nm厚的AlN膜分别采用原子层淀积和溅射淀积技术完成,MISFET的最大漏—源电流、阈值电压以及最大非本征跨导分别为-8.89 mA/mm,-0.22 V以及6.83 mS/mm。
2016年,S. Bajaj等人报道了一种在蓝宝石上AlN衬底上制作的超宽带隙Al0.75Ga0.25N沟道MISFET,采用梯度极化接触技术和凹槽栅结构,栅介质为原子层沉积的Al2O3,器件结构如图2所示。高组分沟道比接触电阻率低至1 × 10-6 Ω · cm2,该项研究工作使得超宽带隙AlGaN基器件广泛应用于电子器件和光电器件。

图2 Al0.75Ga0.25N沟道MISFET结构图
2017年,美国康奈尔大学和圣母大学联合推出在单晶AlN衬底上采用MBE法外延无应变GaN量子阱AlN / GaN FET,AlN / GaN / AlN量子阱双异质结构使该类器件获得了最高迁移率(601 cm2 · V-1 · s-1)和最低薄膜电阻(327 Ω/□),2DEG密度大于2×1013/ cm2。栅长为65 nm,器件的DC漏极电流高达2.0 A/mm并创下当时最高记录,非本征跨导峰值为250 mS/mm,电流截止频率约为120 GHz,通过采用宽带隙厚AlN势垒层使FET的击穿特性和热处理能力得到极大改善,为未来实现高压和大功率微波应变量子阱氮化物晶体管提供了技术基础。
2.2 光电子器件
光电子器件领域是AlN发展最为成熟的领域之一,AlN衬底较低的位错密度(典型值为105 cm-2)已被证实优于Si、SiC和蓝宝石衬底器件,可极大地提高深紫外发光二极管、激光器和探测器的发光效率。目前已有采用AlN衬底的深紫外LED产品的销售,而AlN激光二极管(LD)和雪崩光电二极管(APD)探测器尚未进入实用化。通过使用AlN晶体衬底可使发光波长从UVA(400~320 nm)、UVB(320~280 nm)扩展到UVC(280~200 nm),使用Mg掺杂AlN纳米线阵列可有效改善材料的导电性,可实现高效深紫外光电器件。
2.2.1 LED
大多数AlN UV - LED异质结构生长在c平面蓝宝石衬底上,如图3所示。一般采用MOCVD生长技术,典型生长温度为1000~1200 ℃,有时可达1500 ℃,广泛应用于照明、医疗、水资源净化等领域,具有巨大的经济价值,但存在外部量子效率低(小于10%)等缺陷。

图3 使用AlN缓冲层的深紫外LED的典型外延结构图
2017年,日本信息通信研究机构的S. I. Inoue等人报道了深紫外AlGaN基LED在波长265 nm、输出功率大于150 mW下,采用大面积纳米图形结构制作LED,使光提取效率提高了3倍,可满足实用化需求,为深紫外AlGaN基LED大规模应用奠定了基础。
2018年,美国威斯康星大学麦迪逊分校的D. Liu等人报道了一种在AlN本体单晶衬底上使用p型Si增强空穴注入400 nm厚的AlN同质外延229 nm UV - LED,氮化物异质结构使用金属有机化学气相外延(MOVPE)法淀积,76 A/ cm2电流密度连续波工作状态下AlN / Al0.77Ga0.23N多量子阱(MQW)LED未出现效率下降,实现了本体衬底固有的低位错密度特性,证实了该结构是实现UVC LED的有效方法,未来也可用于激光器中。2018年,德国的N. Susilo等人报道了一种采用MOVPE法生长在溅射和高温退火(HTA)AlN / 蓝宝石衬底上的AlGaN基DUV LED,这种350 nm结构与常规ELO AlN / 蓝宝石LED相比,具有相似的缺陷密度、输出功率特性和外部量子效率(EQE),但曲率(-80 km-1)比ELO结构低1倍,且降低了复杂性和成本。2018年,中国科学院半导体研究所的L. Zhao等人推出了一种在溅射淀积AlN模板上制作的AlGaN基UV - LED,把外延AlN/ AlGaN超晶格结构插入LED结构和AlN模板之间以降低位错密度,这种282 nm LED的光输出功率在20 mA时达 0.28 mW,外部量子效率为0.32%。
2.2.2 激光器
AlN UV激光器适用于激光显微、光谱仪、质谱仪、表面分析、材料处理以及激光光刻等领域。国际上有关AlN紫外激光器的研究相对较少,实现高质量AlN激光器的重要突破是AlN模板与AlN衬底的相互结合。
2016年,R. Kirste等人采用AlN衬底制作出265 nm室温AlGaN紫外激光器,输出功率大于80 mW;同年,C. Liu等人研制了一款采用MOCVD在半极化AlN衬底上制作的波长为250~300 nm的AlInN / GaN量子阱紫外激光器,有源区设计包括一个2.4 nm厚的Al0.91In0.09N / Al0.82In0.18N触发层,0.3 nm厚的晶格匹配GaN层,超薄GaN层的作用是把电子—空穴波函数定位于量子阱(QW)中心位置,从而实现较高的水平极化光增益,与传统的AlGaN QW系统相比,255 nm波长下AlInN - GaN QW结构的水平极化光增益提高了3倍,高达3726 cm-1,通过调整GaN的厚度可为UV激光器提供一种更加高效的有源区设计方案。
2.2.3 光电探测器
基于宽禁带半导体材料(AlN和GaN等)的紫外探测器由于在紫外天文学、紫外探测、紫外通信、生物化学分析、火焰检测等领域的潜在应用得到了广泛研究。
2017年,德国费迪南德·布劳恩研究所研制出的日盲型Al0.5Ga0.5N / AlN金属—半导体—金属(MSM)光电探测器使用薄吸收层和非对称电极设计,在低电压(1 V)条件下实现了较高的外部量子效率值(25%),这种底部照明探测器使用Al0.5Ga0.5N吸收层和AlN缓冲层异质界面,通过使用对称探测和高密度电极对等综合设计使EQE得到进一步提升。2017年,美国东北大学的Z. Y. Qian等人推出了基于高品质因数(Q)的50 nm厚的AlN压电谐振纳米盘的纳机电系统(NEMS)红外探测器,实现了高热阻(9.2 × 105 K/W)和高品质因数(1000),这种AlN NEMS谐振红外探测器具有超快热响应时间(80 μs),探测器的外形尺寸下降到20 μm × 22 μm,品质因数提高了4倍。
国内将AlN材料应用于紫外探测器的研制也取得了较好的成果,2018年,上海大学的沈悦等人对其AlN / CdZnTe基紫外光探测器制备方法及应用技术申请了专利,在1 mm厚的AlN衬底上快速生长了大面积、高质量CdZnTe薄膜,从而使设计的紫外光探测器具有极端环境适应性,以及较强的紫外光响应性。2018年,中山大学的W. Zheng等人报道了一种采用高结晶度多步外延生长技术实现的背靠背型p - Gr /AlN / p - GaN 光电探测器,使用AlN作为光发生载体的真空紫外吸收层,并使用p型石墨烯(透射率大于96%)作为透明电极来收集受激空穴,实现的新型真空紫外光伏检测异质结探测器取得了较理想的光响应度、高外部量子效率,以及极快的温度响应速度(80 ns),比传统光导器件的响应速度提高了10⁴~10⁶倍,这种新技术为实现理想的零功耗集成紫外光伏探测器提供了技术支撑,可使未来空间系统实现更长的服役期和更低的发射成本,同时实现更快速的星际目标探测。
2.3 SAW器件
在已知压电材料中,AlN薄膜的SAW传播速度是最快的,且AlN SAW器件具有良好的化学和热稳定性,以及对外界环境如压力、温度、应力、气体等具有极高的灵敏性,与常规传统Si CMOS技术相兼容,因而成为无源传感、无线传感和移动信号处理的关键部件。随着最近十几年来无线通信技术的飞速发展,SAW传感器、谐振器和滤波器在实现小型化、多功能和高性价比方面有望取代传统半导体器件,成为未来复杂系统的核心技术。
2.3.1 滤波器
AlN滤波器主要包括兰姆波谐振滤波器和SAW / BAW滤波器,兰姆波谐振滤波器在未来单芯片多波段无线通信RF前端系统中使用较多,与SAW滤波器相比更具尺寸优势;AlN在SAW / BAW滤波器中的应用较为成熟,已实现商品化,SAW滤波器多用于中频,BAW滤波器更适合高频应用,且Q值更高,将在4G / 5G等通信领域得到广泛应用。
2015年,天津大学的J. Liang等人推出了一种基于AlN兰姆波谐振器的超小型140 MHz窄带滤波器,采用梯状兰姆波谐振器(LWR)结构,导带插入损耗为2.78 dB,为节约空间进行了优化设计,把电容与LWR单片集成在一起,AlN夹在钼电极中形成三明治结构,分别用作谐振器的压电层和电容器的介质层,在RF通信前端具有很好的应用前景。
2017年,美国卡内基梅隆大学的E. Calayir等人通过AlN MEMS和CMOS芯片的3D异质集成,实现了一种带有自修复功能的窄带滤波器,并且把12个相同的1.15 GHz AlN MEMS子滤波器阵列制作在一个8英寸Si器件上,使滤波器的插入损耗小于3.4 dB,带外抑制(OBR)大于15 dB,通过在AlN MEMS芯片上使用重新分布层使寄生电容下降到原来的1/20,电阻下降到原来的1/5。
2017年,美国Akoustis技术公司的J. B. Shealy等人开发出了一款在SiC衬底上生长单晶AlN压电外延膜的3.7GHz宽带低损耗BAW滤波器,尺寸为1.25 mm × 0.9mm,插入损耗为2.0 dB,器件结构包括生长在150 mm 4H - SiC衬底上的0.6 μm厚的AlN外延层,8层掩模双面晶圆工艺包括溅射淀积金属电极和采用SiC衬底减薄工艺获得的谐振器。该谐振滤波器为实现高频移动、WiFi及其基础设施应用的小型化、大功率和高性能滤波器提供了支持。
2.3.2 传感器
虽然MEMS传感器及其阵列的主流技术仍以Si工艺为主,但AlN MEMS传感器的研究已广泛开展起来,薄膜本体声波传感器在电子鼻和胎压检测等领域应用较多。目前AlN传感器的研究一般是将多个传感器单元集成在同一衬底上,形成传感器阵列,采用激光微加工刻蚀技术进行工艺设计。2015年,俄罗斯的K. A. Tsarik等人报道了一种采用AlN外延膜制作的AlN / AlGaN / GaN HEMT SAW传感器,使用纳米级T型栅和极低厚度势垒,这种单片多层异质结构(MHS)传感器制作在SiC衬底上,采用MBE生长氮化物层,MHS使用厚度为2 μm的高温AlN缓冲层把HEMT与声电子学功能连接起来,测得的SAW的相变灵敏度为6°,主要应用于生物医学领域。2015年,法国的A. Bongrain等人报道了一种制作超薄AlN压电传感器的新技术,采用CMOS技术提高了工艺兼容性,证明了把压电AlN薄膜淀积在Pt上具有更好的压电特性,同时降低了成本,有利于实现单片集成,对于技术的普及和推广十分有益,主要应用于医学检测领域。2015年,Z. Bao等人制作出一种SAW基高灵敏AlN薄膜应变传感器,用于传感器网络,在AlN薄膜上制作了叉指式转换器(IDT),多层膜包括Si衬底上的AlN和Pt / Ti,以及SiO2层,SiO2层用于声—电隔离和温度补偿,Pt膜用于形成c轴取向AlN膜籽晶层,器件的Q值和有效电子机械耦合系数分别为700和0.46%,该传感器在低温(小于400 ℃)下制作而成,可以使用IC后处理技术嵌入到单片振荡器中。2017年,印度的S. Yenuganti等人推出了一种采用硅岛支撑结构的带有AlN压电型SiN谐振梁的微型压力传感器,两层AlN压电膜夹在两层金属电极中,淀积在SiN谐振梁的边端,用于谐振致动和传感,下层电极完全埋入AlN压电层中。2017年,清华大学的S. L. Fu等人报道了一种在蓝宝石衬底上采用DC磁控溅射法制作的AlN外延膜,使用10 nm厚的ZnO缓冲层极大地改善了AlN外延膜的质量,并释放了膜应力。制备的SAW器件获得了近零应力和极低插损,中心频率为1.4 GHz,相位速度为5600 m/s,适用于通信领域的微传感器和微流量计。
2018年,美国Cornell大学的M. Abdelmejeed等人报道了一种CMOS兼容吉赫兹超声脉冲相移基超高速、高分辨率和宽温度范围传感器,其超声脉冲产生于制作在Si衬底上的3 μm厚的AlN压电薄膜转发器,通过检验证明该传感器在30~120 ℃温度范围时相移温度系数为12°/℃,器件的谐振频率为1.6 GHz,数据采集时间为600 ns,实现了极高的线性特性。
2018年,美国Illinois大学的M. Kabir等人报道了一种AlN薄膜压电MEMS声发射传感器,这种传感器制作在Si衬底上,可在柔性和刚性体两种模式下工作,此MEMS器件包括两种不同频率(40 kHz和200 kHz)的传感器,微结构层包括掺杂硅、AlN和金属层,分别用作底部电极、传感层和顶部电极层,0.5 μm厚的AlN用于制作压电薄膜,该MEMS传感器使用100个单元的10 × 10阵列结构(约1 cm2),用来替代传统的声发射传感器。
2.3.3 谐振器
AlN谐振器一般采用两种常规结构,一是薄膜本体声波谐振器(FBAR),另一种是等高线模式谐振器(CMR),FBAR显示出比CMR更高的电子—机械耦合系数(
![]()
),而CMR在实现片上小型化方面更具优势,两种结构的核心技术都是AlN薄膜制备工艺,通过调整AlN膜的厚度和质量可获得理想的器件频率。c轴取向AlN薄膜磁控溅射和干法刻蚀工艺是决定CMR谐振器性能的关键工艺,因与CMOS工艺相兼容,且易于在单芯片上集成多频器件,成为实现小尺寸、高品质因数、高频、低阻特性的保证,是下一代无线通信系统中的实用技术。
2015年,C. Cassella等人提出一种集成了FBAR和CMR两种谐振器优势的超高频AlN MEMS二维模式谐振器(2DMR),可以同时激发横向和纵向的声波,这种谐振器使用在两层相同金属栅中间夹5.9μm厚的AlN膜的三明治结构,在顶部和底部同时使用叉指型转换器,增加了设计灵活性,并获得了较高的电子—机械耦合系数和较低的动态电阻,机械品质因数大于2400,品质因数接近40,中心频率的光刻变化大于10%。2015年,C. Li等人研制出一种用于高温(500 ℃)传感器的AlN SAW谐振器,AlN薄膜采用室温下两步生长法淀积在Pt(50 nm) / Si衬底上,为消除AlN和Pt之间的晶格失配需要在Pt界面先淀积一层200 nm厚的富N AlN缓冲层,之后高速淀积2 μm AlN薄膜,这种AlN谐振器采用的是Pt底部悬浮电极,可实现更高的温度敏感性。2017年,美国桑迪亚实验室的M. D. Henry等人推出一种用于RF滤波器的AlN和Sc0.12Al0.88N CMR谐振器,在AlN中引入钪(Sc)能极大地增强压电极化效应,ScAlN压电膜可改进有效耦合系数,同时保证谐振器具有良好的品质因数。
2017年,清华大学的W. Z. Wang等人报道了一种尺寸为1107 μm × 721 μm的AlN / 4H - SiC多层结构SAW谐振器,这种谐振器采用MEMS兼容工艺制作而成,c轴取向2 μm厚的AlN薄膜采用RF反应磁控溅射工艺淀积在4H - SiC衬底上,AlN的衍射峰值为36.10°,最低半峰全宽值(FWHM)仅为1.19°,同样适合在恶劣环境中应用。2017年,新加坡的N. Wang等人报道了采用硅通孔(TSV)集成技术的AlN压电谐振器,1 μm厚的AlN压电薄膜夹在两层约为0.2 μm厚的Mo电极之间,谐振频率大于2 GHz,动态阻抗小于10 Ω,可用于高频段长期演进(LTE)通信领域,在-40~125 ℃进行750次热循环试验之后没有出现频率漂移,因其超级可靠性和长期稳定性深受青睐。2018年,中国科学院的S. Yang等人推出了一种1 μm厚的AlN/ 蓝宝石双层衬底上制作的单端SAW谐振器,并对SAW波长(λ)、叉指转换器的孔径(LIDT)、反射器光栅的数量(Nref)以及反射器类型等参数对AlN谐振器的性能影响进行了分析,当λ = 8 μm时,声波速度为5536 ms-1,最大回波损耗幅差值为0.42 dB,为0.168%,从而使LIDT从80 μm上升为240 μm,且非常适合高温传感器的应用。
2.4 电力电子器件
AlN具有极高的临界电场、高关态阻断电压、超低导通电阻、超快开关速度以及耐恶劣环境等优势,成为制备耐高压、高温电力电子器件的理想选择,在汽车电子、电动机车、高压输电及高效功率转换等方面具有较大潜力。据预测,AlN器件的功率处理能力是SiC和GaN的15倍,因此被冠名为“下下代电力电子器件材料”,此外开发单晶低位错密度AlN衬底(小于103 cm-2)是实现高质量富AlAlGaN薄膜的基础,在AlN同质衬底上生长富Al AlGaN薄膜与蓝宝石衬底相比可使电阻率极大下降。
2016年,日本的H. Nogawa等人报道了一种采用新型薄AlN衬底制作的大功率绝缘栅双极晶体管(IGBT)模块,实现了高热耗散能力和高功率密度,有望应用于逆变器、工业自动化、再生能源以及电动机车领域,新的AlN薄绝缘衬底采用三种工艺实现:优化烧结条件加强AlN衬底的强度,改变铜线设计以降低应力,优化设计保证绝缘能力,使薄层AlN衬底的热导率达到170 W · m-1 · K-1,强度500 MPa,热膨胀系数为10-6 / K,有效抑制了衬底下焊接断裂的传播,极大地提升了IGBT的使用寿命。2016年,德国的S.Moench等人提出了一种用于2 kW单相光伏逆变器的导热型AlN功率模块,这种采用SiC沟槽型MOSFET的半桥和全桥功率模块使用了AlN衬底混合式集成栅驱动器,采用电—热联合仿真和Al热沉,实现了高开关频率和低热阻,直接键合铜AlN衬底厚度为0.63 mm,最大输出功率2 kW,结-热沉热阻为0.3 K/W,美国加州能源协会(CEC)效率为95.4%,功率密度为3.14 kW/l,超高热导率为170 W · m-1 · K-1,为实现小型、高效电力电子系统提供了支撑。2016年,西安电子科技大学的S. Yang等人报道了带有等离子体增强原子层淀积(PEALD)AlN / GaN异质结构的新型垂直GaN沟槽结构功率器件,新结构在完成n - 高阻层 - n GaN外延沟槽刻蚀之后采用PEALD法淀积了3~5 nm厚的AlN层,实现了具有高电子密度和迁移率的垂直2DEG沟道,阈值电压为2 V,与传统GaNMOSFET相比,这种新型器件实现了9倍跨导和9 kA/cm2的极高漏电流密度,在未来功率开关领域具有应用优势。
3 结语
国内AlN材料和器件技术与国际相比差距较大,要实现大尺寸、高质量、可批量化自主生产的AlN材料还需在材料制备技术方面如:AlN块体单晶的PVT和HVPE技术研究等进行深入研究;开展AlN高温高频大功率HEMT、异质结FET和MISFET微波毫米波器件、260~280 nm波长紫外LED、高Al组分AlGaN紫外APD探测器、SAW / BAW滤波器件等方面的研究。未来AlN材料将在微波毫米波器件、光电子器件、微机械和电力电子等领域发挥巨大的作用。





















评论